Измерение толщины тонкой пленки нанометра является важным аспектом производства и исследований и разработок полупроводников (R & D). Он играет жизненно важную роль в обеспечении обратной связи и руководства по оптимизации для производственных процессов, а также обеспечивает производительность и качество полупроводниковых устройств. Точное измерение тонких пленок нанометра необходимо, так как эти пленки используются в нескольких слоях в пределах полупроводниковых устройств, причем толщина каждого слоя напрямую влияет на функцию и производительность устройства. Методы измерения нанометра используются, чтобы гарантировать, что каждый слой придерживается спецификаций проектирования, и они предлагают ценную информацию о производственном процессе, помогая инженерам оптимизировать эффективность производства и повысить надежность устройства. Для получения дополнительной информации о производстве полупроводников, ознакомьтесь с ресурсами из Ассоциации полупроводниковых отрасли , которая предоставляет комплексные данные и тенденции в области полупроводника.

1. Метод электронного микроскопа
Принцип: Электронный луч, испускаемый из электронного пистолета, проходит через объектив конденсатора и фокусируется в узком, ярком и равномерном пятно, которое облучает образец внутри камеры образца. Электроны, проходящие через образец, несут структурную информацию о образце. Плотные участки образца позволяют проходить меньше электронов, в то время как редкие области пропускают больше электронов. После того, как электронный бал был сфокусирован и увеличен, электронный луч вступает в промежуточные линзы и 1 -й и 2 -й проекционные линзы для дальнейшего увеличения, в конечном итоге проецируя увеличенное изображение электрона на флуоресцентный экран в смотровой камере. Флуоресцентный экран преобразует изображение электрона в видимый свет для наблюдения за пользователем.
Оборудование для обнаружения: сканирующий электронный микроскоп (SEM), просвечивающий электронный микроскоп (ПЭМ)
Общие стандарты:
- ГБ/т 20307-2006 гг.общие правила измерения длины нанометрового уровня с помощью сканирующего электронного микроскопа
- ASTM B748-90 (2021): метод измерения толщины металлического покрытия с использованием сканирующего электронного микроскопа
- ГБ/т 16594-2008 гг.общие правила для сканирующего электронного микроскопа измерения длины м-кронового уровня
- ГБ/т 17722-1999 гг.Метод измерения толщины металлического покрытия с помощью сканирующего электронного микроскопа
Тестовый случай:
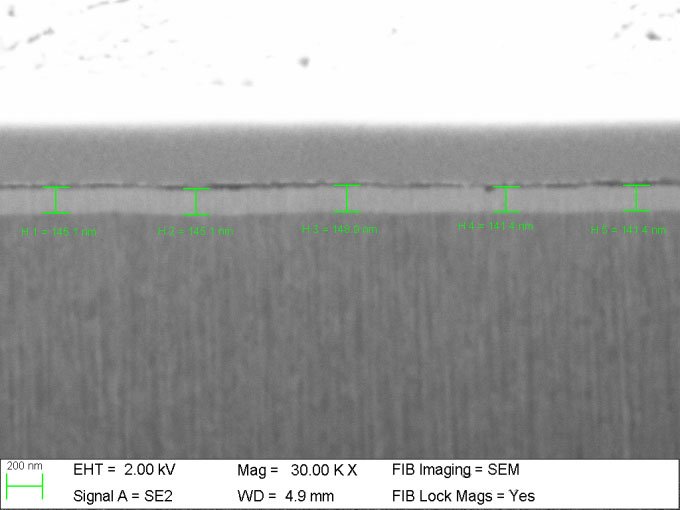
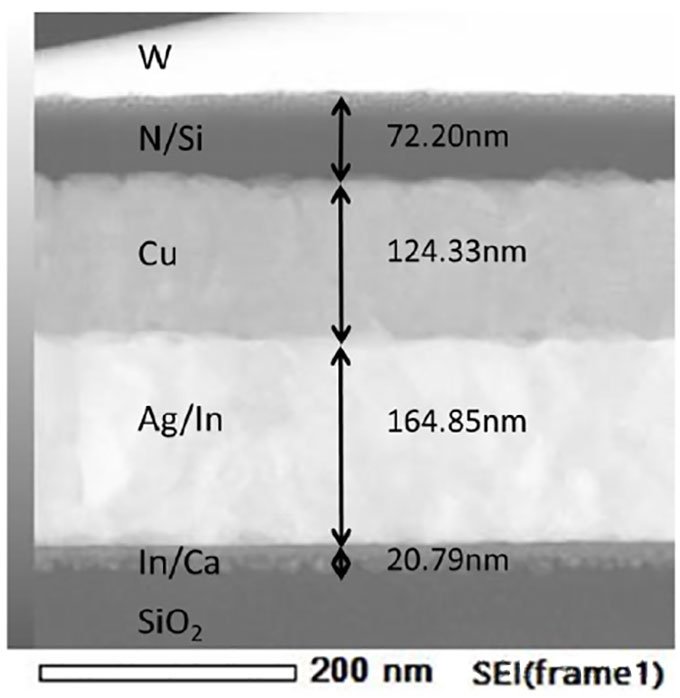
2. Метод профилометра
Принцип: метод профилометра, также известный как метод контакта, включает в себя использование методов предварительного покрытия или пост-диссуции для удаления покрытия в определенных областях субстрата. Это создает шаг между субстратом и покрытием. Когда зонд профилометра проходит на этом этапе, высота стадии (то есть толщины покрытия) может быть определена путем измерения движения зонда и электрических сигналов. Этот метод может измерять толщину покрытия в широком диапазоне от 0,01 до 1000 мкм, при этом погрешность в пределах ± 10%.
Оборудование для обнаружения: шаг
Общие стандарты:
- ГБ/т 11378-2005: измерение толщины металлического покрытия с использованием метода профилометра
- ГБ/т 33826-2017: измерение толщины нанофильм на стеклянных подложках с использованием метода стилуса профилометра
Тестовый случай:

3. Метод атомной силовой микроскопии (AFM)
Принцип: атомная силовая микроскопия (AFM) — это инструмент, используемый для изучения структуры поверхности твердых материалов, включая изоляторы. Он работает путем обнаружения чрезвычайно слабых атомных взаимодействий между поверхностью образца и микросходящим зондом для анализа структуры поверхности и свойств материала.
Оборудование для обнаружения: AFM
Общие стандарты:
- GB/T 40128-2021: Поверхностный химический анализ толщины материала с использованием AFM для материалов дисульфидного слоя молибдена
Тестовый случай:
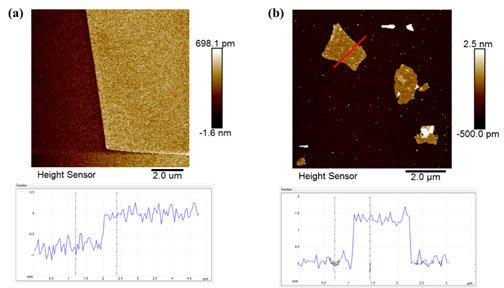
Измерительное оборудование:

 kyiregong@yousantape.com
kyiregong@yousantape.com +86 19168512075
+86 19168512075









